이 블로그는 원래 cimetrix.com에 게시되었습니다.
에서 본 시리즈 소개 우리는 이번 및 향후 게시물에서 소개할 애플리케이션이 직접적으로 해결하는 업무 목표를 가진 제조 분야 이해관계자 일부를 나열했습니다. 두 번째 기사우리는 주요 이해관계자 그룹의 관심사를 특정 EDA 인터페이스 요구사항으로 매핑하는 과정을 설명했으며, 이는 구매 사양서에 직접 포함될 수 있습니다. 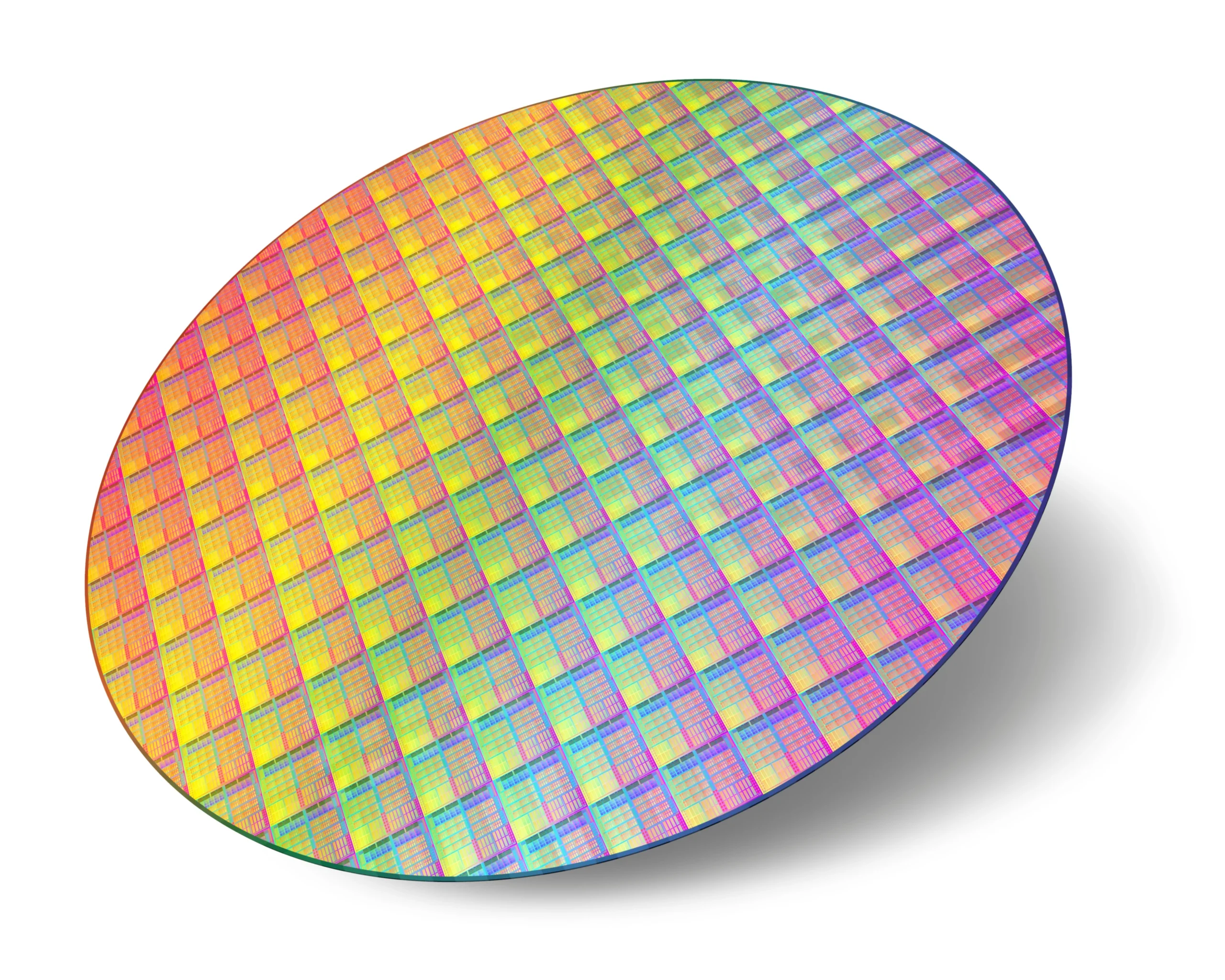
이 글에서는 인터페이스 요구사항 중 일부가 모든 장비 유형에 걸쳐 일반적으로 적용 가능한 중요한 공장 애플리케이션, 즉 "실시간 처리량 모니터링"을 어떻게 지원하는지 설명하겠습니다. 이 애플리케이션은 요구사항 명세서에 언급된 SEMI 표준을 장비 공급업체가 얼마나 충실히 구현했는지에 따라, 맞춤형 코드나 구성 없이도 다양한 장비 유형과 현실적으로 작동할 수 있습니다. 이 강력한 개념은 팹 자동화 팀의 소프트웨어 엔지니어링 생산성을 크게 향상시키므로, 이를 가능하게 하는 원리를 자세히 설명하겠습니다.
문제 진술
본 애플리케이션은 장비 처리량 성능을 실시간으로 모니터링하고, 어떠한 이유로든 "정상" 상태에서 벗어날 경우 경보를 발령하는 문제를 해결합니다. 이는 특히 병목 장비(예: 리소그래피 트랙 및 스캐너)에 중요합니다. 처리량 손실은 라인 전체에 파급 효과를 일으켜 생산 손실과 이에 따른 수익 및 이익 손실로 이어지기 때문입니다. 간단히 말해, "병목 장비에서 손실된 시간은 결코 되찾을 수 없다."
솔루션 구성 요소
이 애플리케이션은 주로 기기 내 기판 이동 경로와 해당 기기 유형(공정, 계측, 검사, 분류 등)에 적합한 레시피 실행을 기록하는 장비 이벤트 데이터를 필요로 합니다. 이 정보를 바탕으로 애플리케이션은 실시간으로 공정 시간을 계산하고 현재 값을 예상("정상") 값과 비교합니다.

이것은 처음 보기에 생각보다 간단하지 않습니다. 왜냐하면 기대값은 제품 유형, 공정 유형, 재료 상태, 층, 레시피 및 여러 다른 요인에 따라 달라질 가능성이 높기 때문입니다. 종합해 보면, 특정 공정 목적에 있어 서로 다른 배치 간의 "동등성"을 결정하는 일련의 요인들을 "컨텍스트"라고 부릅니다. 이 응용 분야에서 컨텍스트 매개변수는 공정 시간의 변동을 살펴볼 때 동일한 조건(사과와 사과)을 비교하도록 보장합니다.
EDA(장비 데이터 수집) 표준 활용
"EDA"에는 Freeze II / 0710 제품군의 표준뿐만 아니라 SEMI E164(EDA 공통 메타데이터), E157(모듈 공정 추적) 및 참조를 통해 전체 GEM 300 제품군도 포함됩니다. 이를 통해 웨이퍼 이동 및 단계별 레시피 실행을 정밀하게 추적하는 데 필요한 이벤트 지원의 세분화 및 폭을 보장할 뿐만 아니라, 장비 유형이나 공급업체에 관계없이 해당 이벤트 및 관련 매개변수의 명명 규칙을 명시합니다 .
장비 자동화 구매 사양서에 "참조된 300mm SEMI 표준에 정의된 모든 상태 기계, 상태, 상태 전환 이벤트 및 객체 속성은 표준에 명시된 대로 정확히 구현 및 명명되어야 한다"는 조항이 포함되어 있다면, 진정한 범용 처리량 모니터링 애플리케이션을 작성하는 데 필요한 모든 정보는 필요 시 즉시 제공될 것입니다.
다음 SEMI 표준들(E90(기판 추적), E157(모듈 공정 추적), E40/E94(가공/제어 작업 관리), E87(캐리어 관리))의 정보만으로 강력한 실시간 처리량 모니터링 알고리즘을 구현할 수 있습니다. 하렐 상태도, 관심 이벤트 및 이들 중 일부(E90 및 E157)에 대한 EDA 메타데이터 모델 표현*은 아래 그림에 제시되어 있습니다.


각 이벤트(각 그림의 가장 오른쪽 그림)에 대해 제공되어야 하는 매개변수 정보는 하나 이상의 "이벤트 요청"을 포함한 "데이터 수집 계획(DCP)"이라는 EDA 구조를 통해 최소한 또는 최대한 수집될 수 있습니다. 이러한 기능에 대한 자세한 내용은 SEMI E134(데이터 수집 관리) 사양을 직접 참조하거나 당사 웹사이트에서 제공되는 방대한 교육 자료를 검토하십시오 .
EDA 표준의 또 다른 장점은 다중 클라이언트 지원 기능입니다. 이 기능은 자동화 소프트웨어 팀 구성원들이 다른 애플리케이션과 독립적으로 해당 애플리케이션의 데이터를 수집 및 처리할 수 있게 함으로써 생산성과 대응력을 높여줍니다. 특히, 처리량 모니터링 기능은 일반적으로 팹 운영에 부정적 영향을 미칠 수 있어 매우 신중하게 관리되는 GEM 명령 및 제어 기능을 호스팅하는 시스템과 별도로 구현될 수 있습니다.
핵심 ROI 요소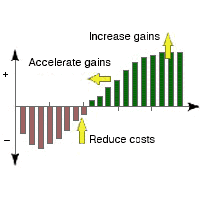
이 시리즈의 첫 게시글에서 언급했듯이, 이 애플리케이션은 단순히 EDA 지원 장비로 구축 및 배포할 수 있는 수준을 넘어섭니다… 사실 이미 구현되어 실제 생산 제조 현장에서 실질적인 이점을 제공하고 있습니다! 구체적으로, 이 애플리케이션이 영향을 미친(그리고 혜택을 제공한) ROI 요소는 생산성 편차 평균 탐지 시간(MTTD, 50% 감소), 선택된 장비 처리량 향상(3~5%), 그리고 전체 사이클 시간 단축(단계적 구현 과정으로 인해 정확히 정량화하기 어려움)을 포함합니다.
물론 이러한 결과는 제조사의 팹 가동률, 운영 전략 및 전반적인 자동화 역량에 따라 달라지지만, 거의 최대 가동률로 운영되는 최첨단 생산 웨이퍼 팹을 대표합니다. 그러나 이는 매우 일반적인 투자수익률(ROI) 요소이므로 대부분의 기업은 이러한 개선 효과를 실제 재무적 측면에서 쉽게 정량화할 수 있습니다.
마지막으로…
언제나처럼 여러분의 피드백을 환영하며, 스마트 제조의 여정을 함께 나누기를 기대합니다.

*장비 메타데이터 모델 조각의 시각화는 Cimetrix ECCE Plus 제품(Equipment Client Connection Emulator)에서 생성된 것입니다.
